Gần đây TSMC đã bắt đầu đưa vào hoạt động dây chuyền sản xuất chip mới của mình dùng công nghệ Integrated Fan-Out (InFO), và đây có thể là lý do vì sao Apple sẽ thuê TSMC làm 100% vi xử lý A10 chứ không còn chia một phần cho Samsung. Công nghệ InFO cho phép tạo ra những SoC có độ dày chỉ từ 0,8mm hoặc thậm chí là thấp hơn nữa, để các bạn dễ so sánh thì hiện nay mức trung bình là 1mm. Nếu chip mỏng đi thì các hãng phần cứng cũng có thể làm cho điện thoại, máy tính bảng của họ trở nên mỏng hơn. Ngoài ra, do khoảng cách giữa đế chip và bo mạch cũng gần lại nên nó sẽ tản nhiệt nhanh hơn, vậy nên mức điện năng tiêu thụ tối đa cũng có thể được nâng cao và giúp tăng khoảng 20% hiệu năng.
InFO thực chất là một phương pháp đóng gói chip mới, còn phương pháp hiện đang được sử dụng phổ biến là Flip Chip-PoP (Package on Package). Trong phương pháp này, lúc con chip còn nằm trên tấm wafer thì nó được gắn các chân tiếp xúc vào, cắt ra khỏi wafer và lật lại (thế nên mới gọi là flip). Sau đó, người ta đem nung nóng chúng để các chân tiếp xúc chảy ra và tạo thành bề mặt truyền điện / dữ liệu. Kế tiếp, một cái đế (die, hay còn gọi là package substrate) sẽ được áp vào khiến con chip nằm hơi lồi lên ở chính giữa (giống CPU desktop).
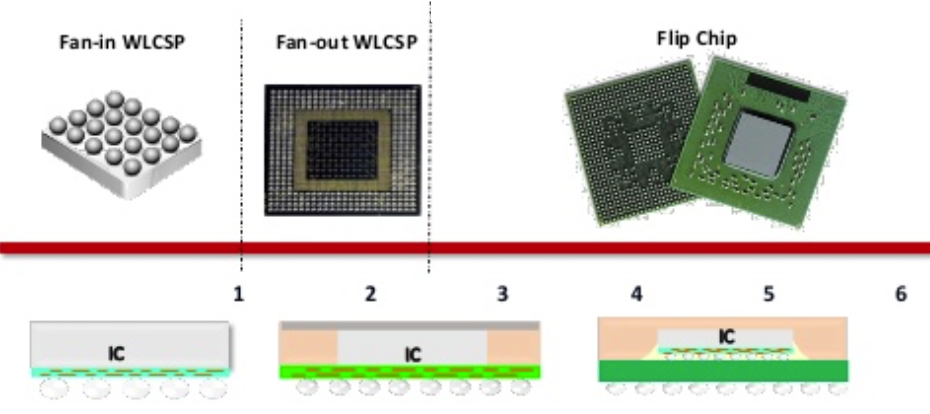
Trong khi đó, InFO thì để con chip nằm dưới cùng và bọc bên ngoài một bộ vỏ, lúc này chip cũng đóng vai trò là một phần đế luôn nên chân tiếp xúc sẽ nằm ngay trên chip, không còn bị ngăn cách bởi cái bo mạch dày nữa. Chính vì vậy mà chip mới có thể mỏng hơn, khoảng cách giữa đế với bo mạch cũng gần hơn. Và bởi vì không còn cần đến package substrate truyền thống nên chi phí sản xuất cũng rẻ hơn.
Quay trở lại với vấn đề của Samsung, có vẻ như hiện tại công ty vẫn còn đang dùng Flip Chip-PoP để làm chip và không nhiều nhà sản xuất đã ứng dụng InFO. Chính vì vậy mà TSMC mới giành được hợp đồng "trọn gói" từ Apple. Các nhà phân tích tin rằng theo thời gian InFO sẽ càng trở nên phổ biến hơn, và rất có thể Samsung cũng sẽ sớm triển khai InFO cho chính mình.
InFO thực chất là một phương pháp đóng gói chip mới, còn phương pháp hiện đang được sử dụng phổ biến là Flip Chip-PoP (Package on Package). Trong phương pháp này, lúc con chip còn nằm trên tấm wafer thì nó được gắn các chân tiếp xúc vào, cắt ra khỏi wafer và lật lại (thế nên mới gọi là flip). Sau đó, người ta đem nung nóng chúng để các chân tiếp xúc chảy ra và tạo thành bề mặt truyền điện / dữ liệu. Kế tiếp, một cái đế (die, hay còn gọi là package substrate) sẽ được áp vào khiến con chip nằm hơi lồi lên ở chính giữa (giống CPU desktop).
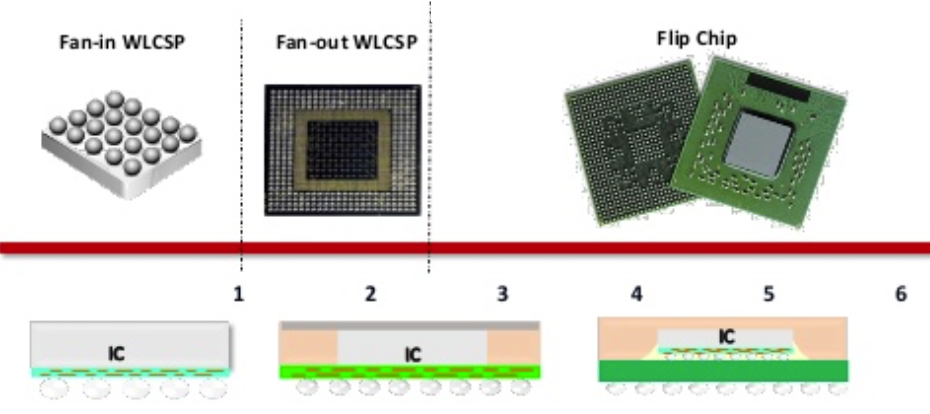
Trong khi đó, InFO thì để con chip nằm dưới cùng và bọc bên ngoài một bộ vỏ, lúc này chip cũng đóng vai trò là một phần đế luôn nên chân tiếp xúc sẽ nằm ngay trên chip, không còn bị ngăn cách bởi cái bo mạch dày nữa. Chính vì vậy mà chip mới có thể mỏng hơn, khoảng cách giữa đế với bo mạch cũng gần hơn. Và bởi vì không còn cần đến package substrate truyền thống nên chi phí sản xuất cũng rẻ hơn.
Quay trở lại với vấn đề của Samsung, có vẻ như hiện tại công ty vẫn còn đang dùng Flip Chip-PoP để làm chip và không nhiều nhà sản xuất đã ứng dụng InFO. Chính vì vậy mà TSMC mới giành được hợp đồng "trọn gói" từ Apple. Các nhà phân tích tin rằng theo thời gian InFO sẽ càng trở nên phổ biến hơn, và rất có thể Samsung cũng sẽ sớm triển khai InFO cho chính mình.
Nguồn: Barron
